SK hynixは、最近ロジック(システム)半導体の設計人材を大量に採用しているようだ。メモリ半導体企業である同社が、メモリ分野のエンジニアではなく、グラフィック処理装置(GPU)や中央処理装置(CPU)などのロジック半導体の設計専門家を次々と採用するのは、異例のことだ。さらに、多くの主要人材がチームを組んでロジック半導体設計の勉強に取り組んでいると伝えられている。業界関係者は、「10年以内に半導体の“ゲームのルール”が変わる可能性がある」と述べ、「メモリ半導体とロジック半導体を区別することが大きな意味を持たなくなるかもしれない」と話している。
これについて専門家は、チップ設計(ファブレス)と受託生産(ファウンドリ)、メモリ・ロジックなどに比較的明確に区分されていたグローバル半導体生態系の秩序が、まるごと揺らぐ兆しであると見ている。人工知能(AI)時代の関連需要が爆発的に増加する中、高帯域幅メモリ(HBM)の第6世代に相当するHBM4が、早ければ2026年から本格的に量産に入る予定だ。現在の市場では、第5世代のHBMである最新のHBM3EがNVIDIA製品などに搭載され、AIブームを牽引している。
HBMはメモリ半導体の救世主の役割を超えて、既存の半導体秩序に亀裂を入れる可能性があるという兆候が現れている。特にHBM4は、これまでの半導体とは全く異なる概念のものになる可能性が高い。業界によると、SK hynixはHBM4からメモリ半導体とロジック半導体を同じダイに一緒に実装する方式に挑戦することにしたという。これは、半導体開発の歴史上初めて、ロジック半導体(GPU)とメモリ半導体(HBM)が完全に一体となって動く「複合半導体」の生産が現実化しすることを意味するのだ。
現在、HBMのような先進的なメモリ半導体は、ロジック半導体であるGPUチップの隣にできるだけ近づけて効率を出す方向で開発されている。ロジックダイの上にDRAMを重ねて積み上げたHBMが搭載されているが、GPUの主要な演算機能は別のチップでHBMとは分離されている。
最近注目されている先進的なパッケージング技術も、メモリとロジックの2つのチップをできるだけ近づけて接続するために生まれた。「インターポーザー」という部品の上にメモリとロジックチップを水平に接着し、それを配線で接続する方式だ。つまり、2つのチップがまだ完全な一体ではないために、パッケージング技術を利用して、まるで1つのチップのように接続する必要があると言うわけだ。このため、通路の役割をする配線を増やしたり、HBMの層数を高めることで性能向上が図られてきた。
しかし、HBM4を始めとして、GPUの主要な演算機能が本格的にメモリ半導体があるロジックダイ側に移り、HBMと一緒に実装されるとなれば話は変わってくる。KAISTの金正浩教授は、「例えるならば、アパート(メモリ半導体)と商店(ロジック半導体)が地下道でつながれていた構造から、ついに真の意味での“複合半導体時代”への第一歩を踏み出した」と述べ、「今後2~3世代が経過し、発熱問題などが解決されれば、インターポーザーなしでもHBMとGPUが一体として動作することができるだろう」と話している。
SK hynixは、NVIDIAを含む複数のグローバルファブレス企業とHBM4の設計方式について議論中である。SK hynixとNVIDIAが最初からチップを共同設計し、TSMCに生産を委託する方式で半導体を製造する可能性が高い。メモリ半導体とロジック半導体が同じダイで一体となって動くためには、共同設計が不可欠だからだ。
NVIDIAの王座を狙う主要なグローバルファブレスも、このような共同設計デザインを模索中である。SK hynixが最近ロジック半導体の設計学習に乗り出した背景には、こうした事情があるのだ。SK hynixの関係者は、「HBMの性能が向上すると、ダイに余裕のスペースが生まれる」と述べ、「HBMの空いたスペースを提供するので、GPUもこちらに移動してシナジーを生み出してみようというアイデアだ」と説明している。
メモリ半導体とファウンドリの両方を持つSamsung Electronicsも、設計段階でNVIDIAなどのグローバルファブレスと協力した後、HBMとGPUをそれぞれ自社で生産し、一体として提供する作業まで一括供給する可能性が考えられる。半導体業界では、NVIDIAなどのファブレス企業が握っているハードウェアの覇権がメモリ企業に一部移動する地殻変動が起こる可能性があると見ている。
HBM 4は、メモリ半導体とロジック半導体の区分が消え始めた最初のチップとして、IT史に記録される可能性が高い。グローバルHBM市場は、今年20億ドルから2027年には63億ドルまで急成長すると予測されている。HBMとロジック半導体が設計段階から統合されれば、関連市場の規模は現在の数倍に膨れ上がるだろう。
IP(半導体設計資産)とプロセス分野でも大きな変化が避けられないだろう。「複合半導体時代」が到来すれば、メモリ半導体企業が主導権を握ることができる可能性も考えられる。業界関係者は、「単純なカスタム“DRAMファウンドリ”を超えて、もっと大きな世界が開かれる可能性がある」と述べ、「NVIDIA・AMDのような大物たちも、SK hynixやSamsungが作った盤の上で設計しなければならなくなるかも知れない」と話しているようだ。
Sources
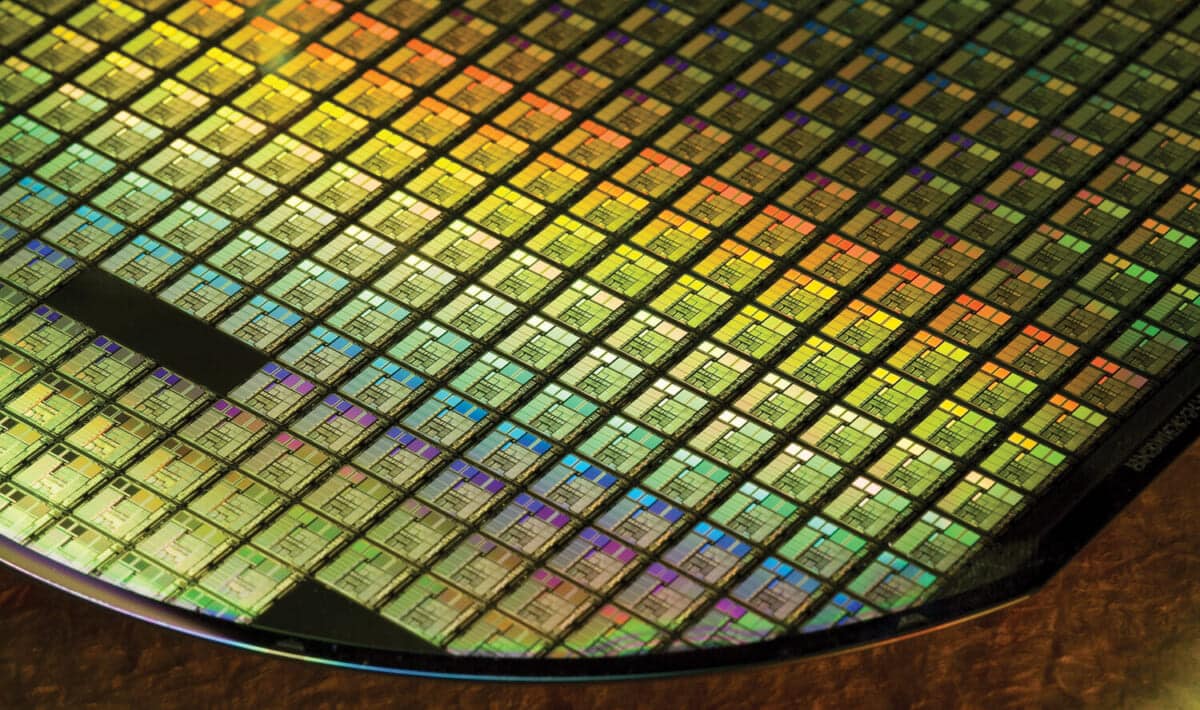







コメントを残す