Intelは、8月22日(現地時間)から行なわれる半導体業界のカンファレンス「Hot Chips 34」にて、同社が2023年に導入を計画しているクライアント向けSoC「Meteor Lake」「Arrow Lake」、「Lunar Lake」に採用する3D Foverosチップ設計に関するさらなる新しい詳細を明らかにした。
先日、TrendForceがIntelのMeteor Lakeは、GPUタイル/チップレットをTSMCの3nmノードから5nmノードに変更したため、市場への投入が遅れると報じていた。Intelは、GPUタイルにどのノードを採用するかについて、具体的な情報を明らかにしていないが、同社の担当者は、GPUタイルの採用予定ノードは変わっておらず、プロセッサは2023年のリリースに向けて計画通り順調に進んでいると述べている。
ここで注目すべきは、IntelがMeteor Lakeチップの構築に用いる4つのタイルの、自社では1つだけを製造し、残りの3つはTSMCが製造することだ。
以下の画像は、Intelが共有した新しいMeteor Lakeのダイフットプリント画像だ。Intelによると、これは6 つのパフォーマンスコアと 2つの高効率コアを搭載したモバイル向けプロセッサのものとのこと。それぞれ、GPUの「GFXタイル」「SoCタイル」「IOタイル」そして、CPUの「COMPUTEタイル」の4つのタイルが配置されていることが見て取れる。
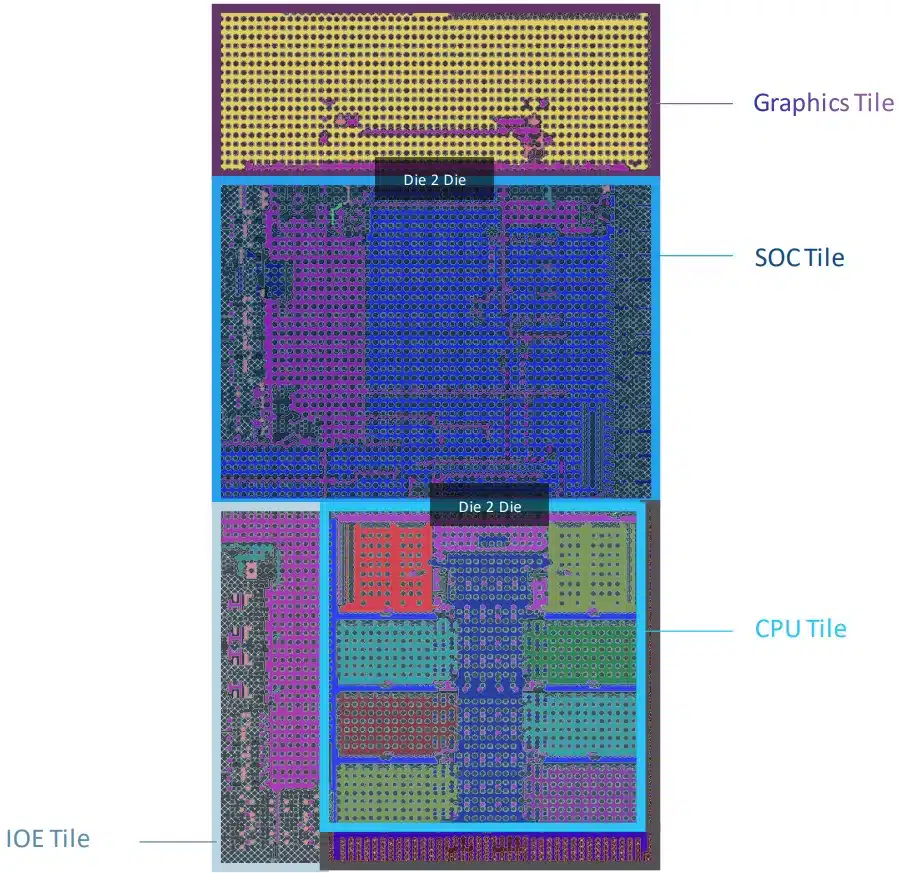
今回、このダイのパッケージングの詳細が明らかにされた。
Meteor Lakeでは、新たに「Foveros」3Dパッケージング技術が用いられる。これにより、Foverosインターコネクトを備えた1つのベースダイの上に、チップレットを垂直に積み重ねることができるようになる。
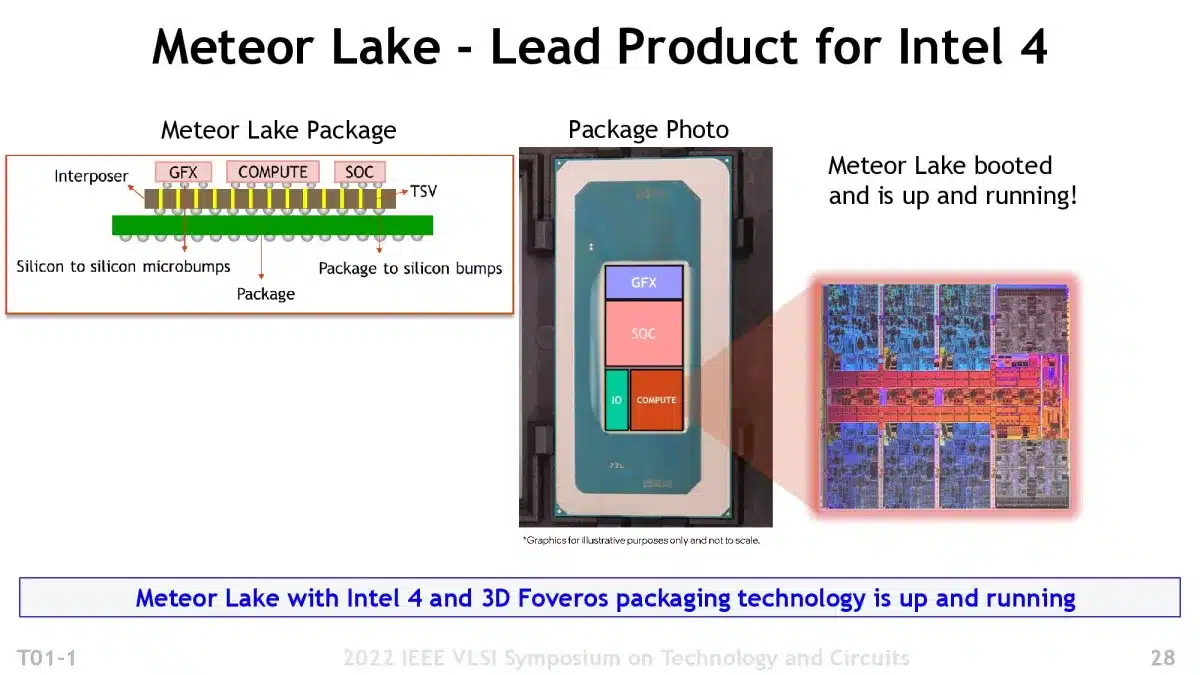
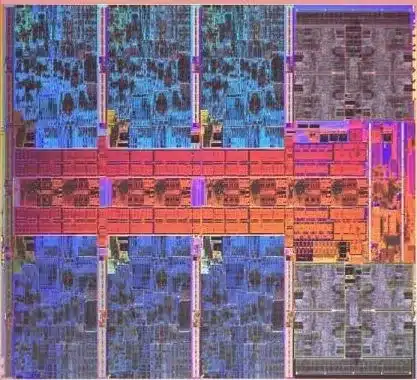
Intelは、Ponte VecchioやRialto Bridge GPU、Agilex FPGAにもFoverosを採用しており、同社の次世代製品のいくつかにとって基礎となる技術になるようだ。
Intelは、Foverosインターポーザ/ベースタイルの上に、4つのMeteor Lakeチップレット(Intel用語で「タイル」と呼ばれる)を配置することを明らかにした。チップレットとインターポーザはTSV接続で配線され、インターポーザにはロジックはない。3Dパッケージング技術「Foveros」は、アクティブインターポーザもサポートする。Intelは、低コストで低消費電力に最適化された22FFL(Intelの22nmプロセスルール)でFoverosインターポーザを製造しているという。Intelは、このノードの新しい「Intel 16」もファウンドリサービス用に持っているが、IntelがMeteor Lakeのベースタイルにどのバージョンを使うかは明らかではない。
Intelは、このインターポーザーの上に、Intel 4プロセス(従来Intelが7nmプロセスと呼んでいたもの)を採用したCOMPUTEタイル、IOタイル、SoCタイル、GFXタイル(tGPU)を搭載することになる。これらのユニットはすべてIntelが設計し、Intelのアーキテクチャを採用しているが、I/Oタイル、SoCタイル、GPUタイルは外部のファウンドリであるTSMCが製造する。つまり、Intelが製造するのは、CPUとFoverosタイルだけということになる。
I/OタイルとSoCタイルはTSMC N6プロセスで製造され、GFXタイルはTSMC N5プロセスになるとのことだ。(ちなみに、IntelはI/Oタイルを「I/O Expander」と呼んでおり、IOEという名称が使われている)。
| Intel Meteor Lake タイル | 製造業者/ノード |
|---|---|
| COMPUTE タイル(CPU) | Intel / Intel 4 |
| 3D Foveros ベースタイル | Intel / 22FFL |
| GFXタイル (tGPU) | TSMC / N5 (5nm) |
| SoC タイル | TSMC / N6 (6nm) |
| IOE タイル | TSMC / N6 (6nm) |
Foverosは36ミクロンのバンプピッチ(配線密度の重要な指標)を採用している。Foverosのロードマップには、将来の設計で25ミクロンや18ミクロンのピッチも含まれている。将来的には、ハイブリッドボンディングインターコネクト(HBI)を使って1ミクロンのバンプピッチに到達することも理論的には可能だとIntelは言う。
3Dパッケージの最大の懸念はコストであり、FoverosはIntelにとって、その最先端のパッケージ技術で初めて量産に踏み出す極めて意欲的な物だ。しかし、Intelは、Foverosパッケージで製造されたチップは、標準的なモノリシック(単一ダイ)チップ設計と極めて価格競争力があり、場合によっては、より安価になる可能性もあると述べている。
また、一部でうわさのあった、IntelがGFXタイルの製造にTSMCのN3プロセステクノロジーを使っているという噂を否定しており、このノードがMeteor Lakeの発売スケジュールに影響を与えることは単純にあり得ないことだとしている。
Intelは、Meteor Lakeが2023年、Arrow Lakeが2024年に発売されることを確認した。このシリーズは、デスクトップとモバイルのプラットフォーム向けに発売される予定だ。また、Arrow Lakeの後に予定されているLunar Lakeは、主に15Wのローエンドチップ向けに設計されていることを確認した。しかし、これはデスクトップチップの可能性を否定したわけではない。
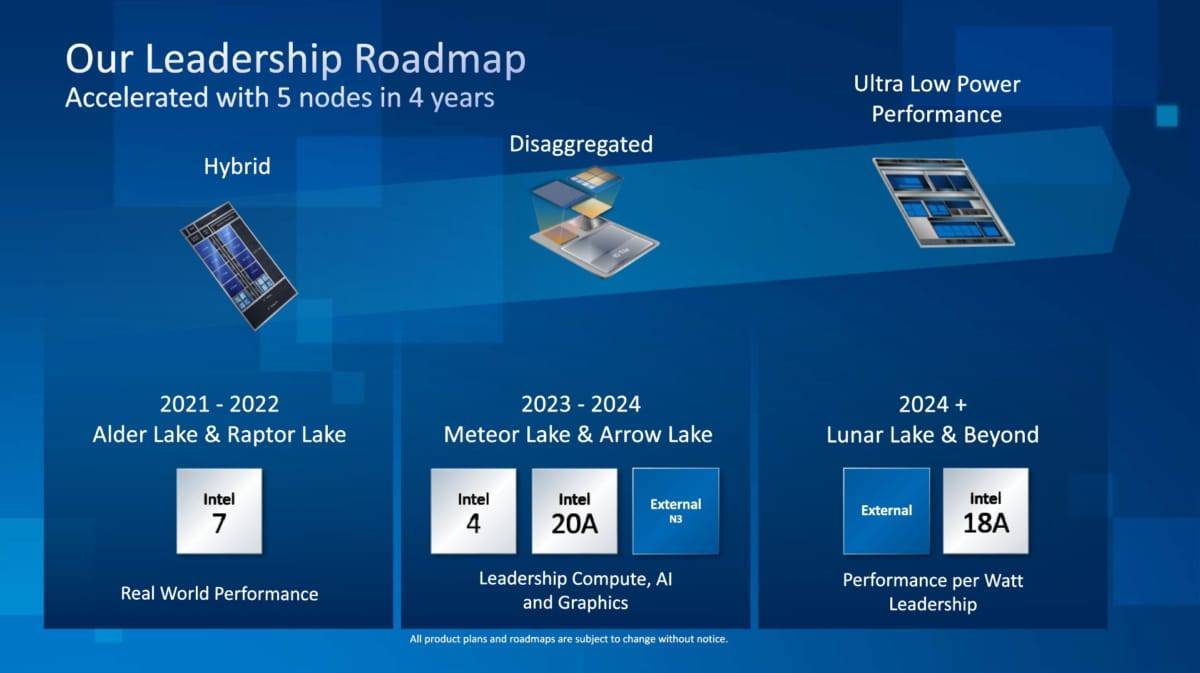







コメントを残す