Intelは、チップ設計の面で、今まであまり顧みられることのなかった“基板”そのものの材料において、大きなブレークスルーを達成したことを発表した。これまで用いられてきた有機材料に変わり、同社はガラスを用いることでより先進的なチップ設計が可能になるという。
これまで、チップ設計の次の技術を語るとき、話題に上ることと言えばより多くのコアを詰め込み、クロックを高速化し、トランジスタを縮小し、3Dスタッキングすることばかりだった。だがそれと同様に重要なのは、これらのコンポーネントを保持し接続するパッケージ基板だ。だがこの素材が話題になることはほとんどなかった。
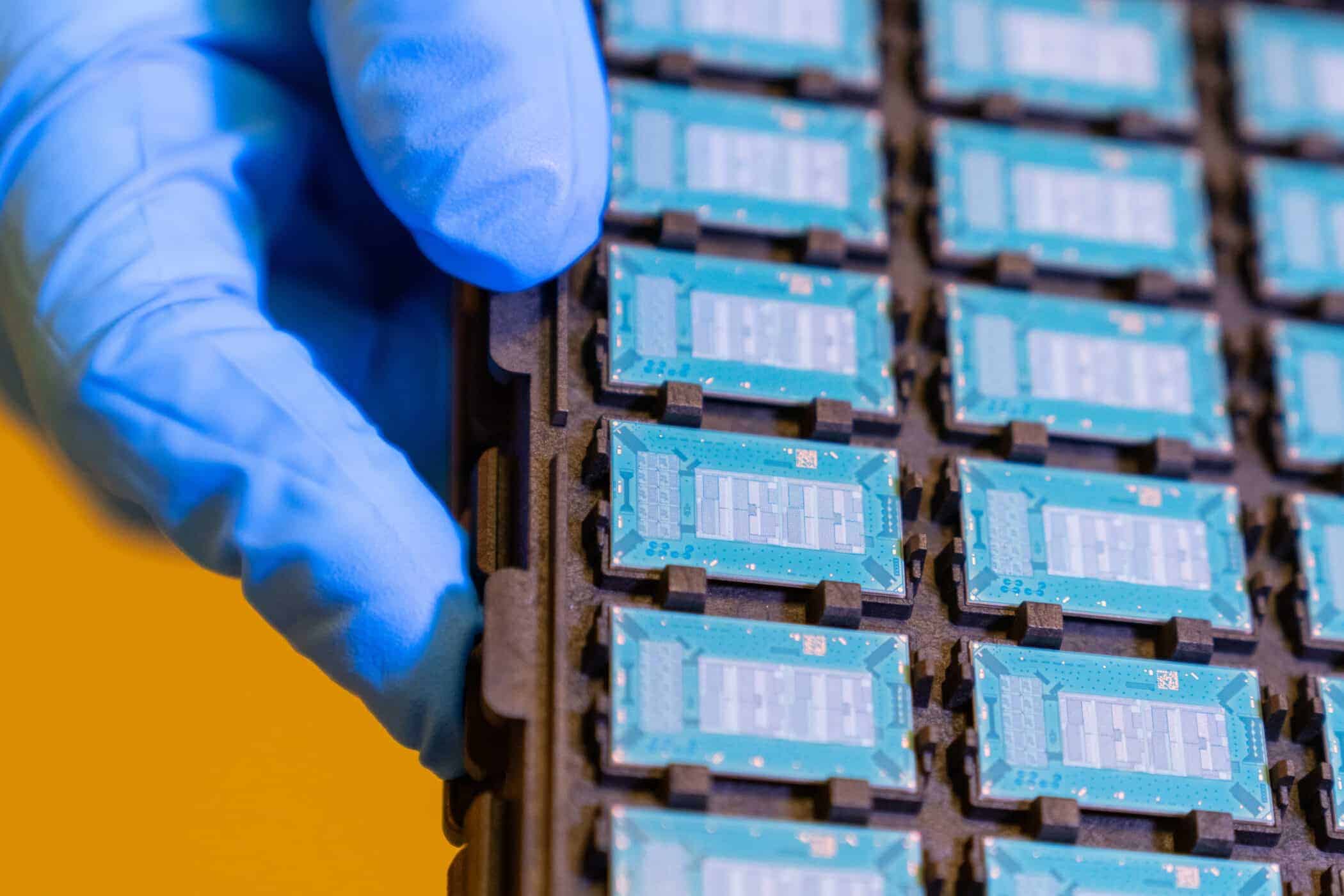
Intelは少なくとも10年前からこのガラス基板を研究してきたとのことだ。今回の発表の中で、同社はこれが有機材料に取って代わることが出来ると感じている事を述べている:
ガラス基板は優れた機械的、物理的、光学的特性を有しており、現在使用されている有機基板と比較して、パッケージ内でより多くのトランジスタを接続することができ、より優れたスケーリングを提供し、より大きなチップレット複合体(「システム・イン・パッケージ」と呼ばれる)のアセンブリを可能にします。チップ・アーキテクトは、より多くのタイル(チップレットとも呼ばれる)をより小さなフットプリントで1つのパッケージに詰め込むことができるようになります。
Intelによれば、同じスペースにより多くのトランジスタを詰め込むことに加え、その他にも大きな特徴を持つ。その際立った特徴のひとつは、リソグラフィーの焦点深度を向上させる超低平坦性と、相互接続のための優れた寸法安定性である。これは、Intel独自のPonte Vecchioのような、現在のデバイスに比べてさらにチップレットが多い次世代SiPにとって重要である。このような基板はまた、優れた熱的・機械的安定性を提供するため、より高い温度に耐えることができ、データセンター・アプリケーションにおいてより強靭なものとなる。
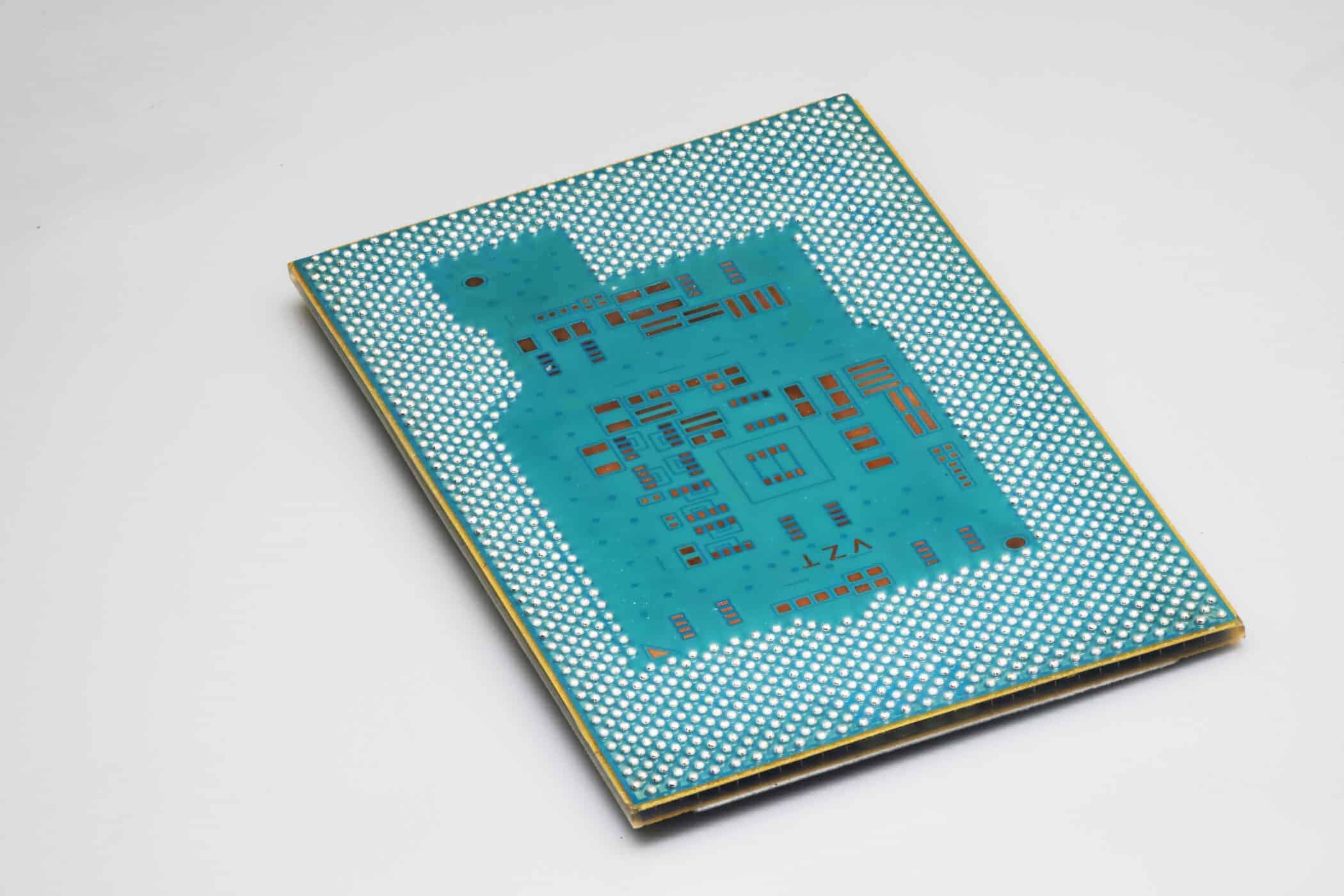
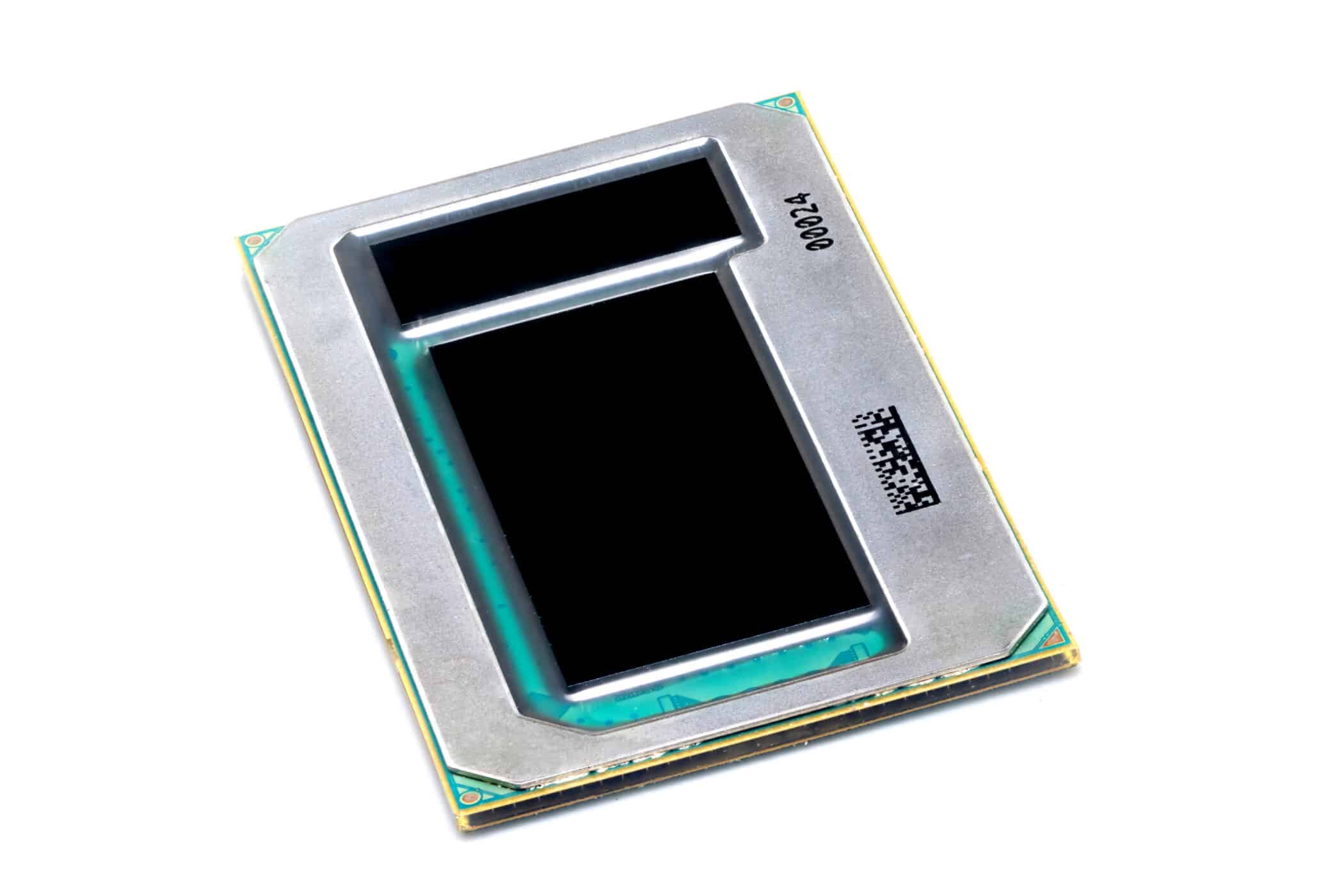
加えて、Intelによれば、ガラス基板はインターコネクト密度を大幅に向上させることが可能であり(すなわち、よりタイトなピッチ)、次世代SiPの電力供給と信号配線に極めて重要なこの面で、10倍の増加が可能になるという。特に、Intelは<5/5um Line/Spaceと<100um Through-glass via (TGV)ピッチについて話しており、これにより基板上のダイ間バンプピッチ<36umとコアバンプピッチ<80umが可能になる。さらに、ガラス基板はパターン歪みを50%低減し、リソグラフィの焦点深度を向上させ、より精密で正確な半導体製造を可能にする。
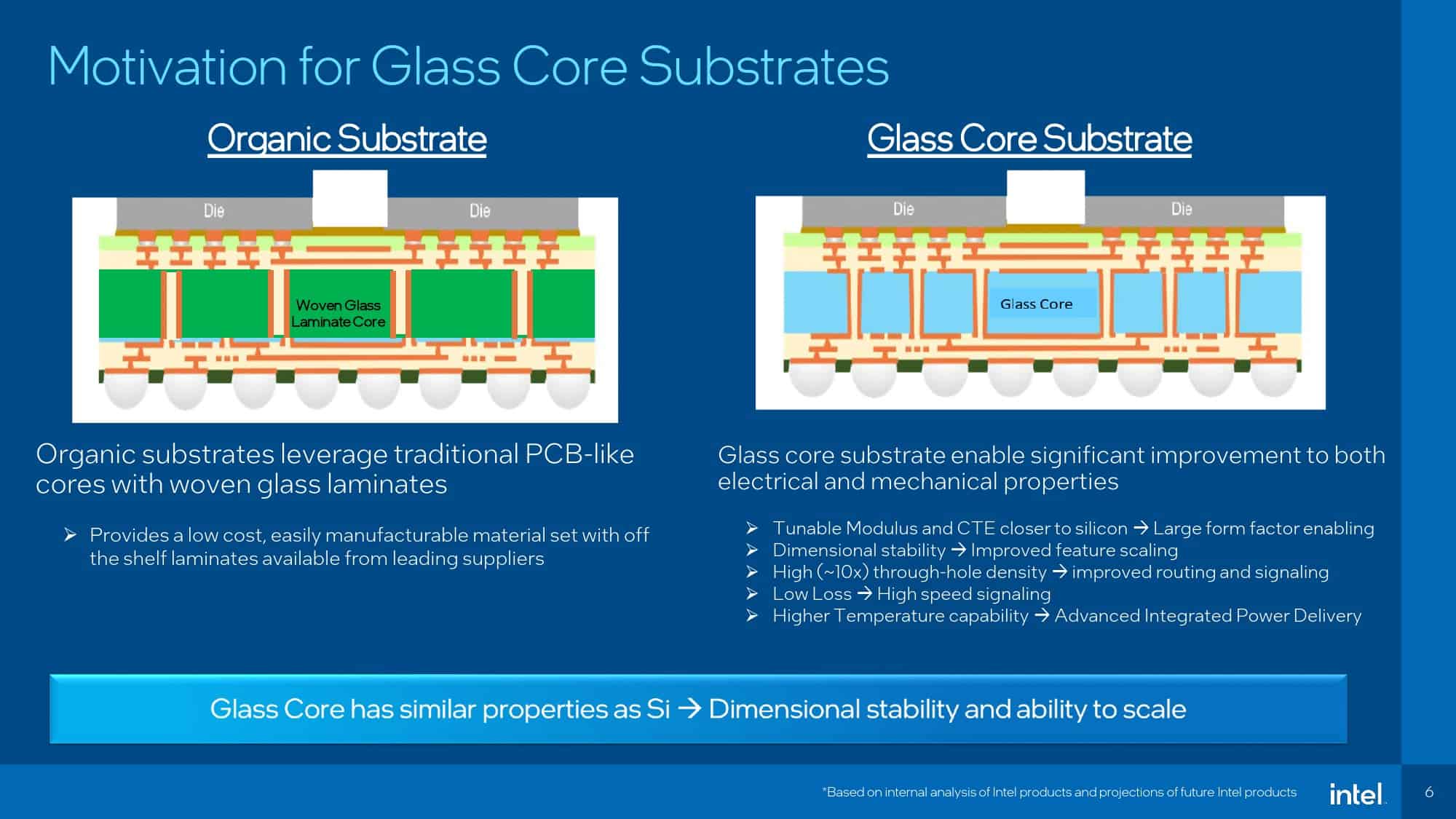
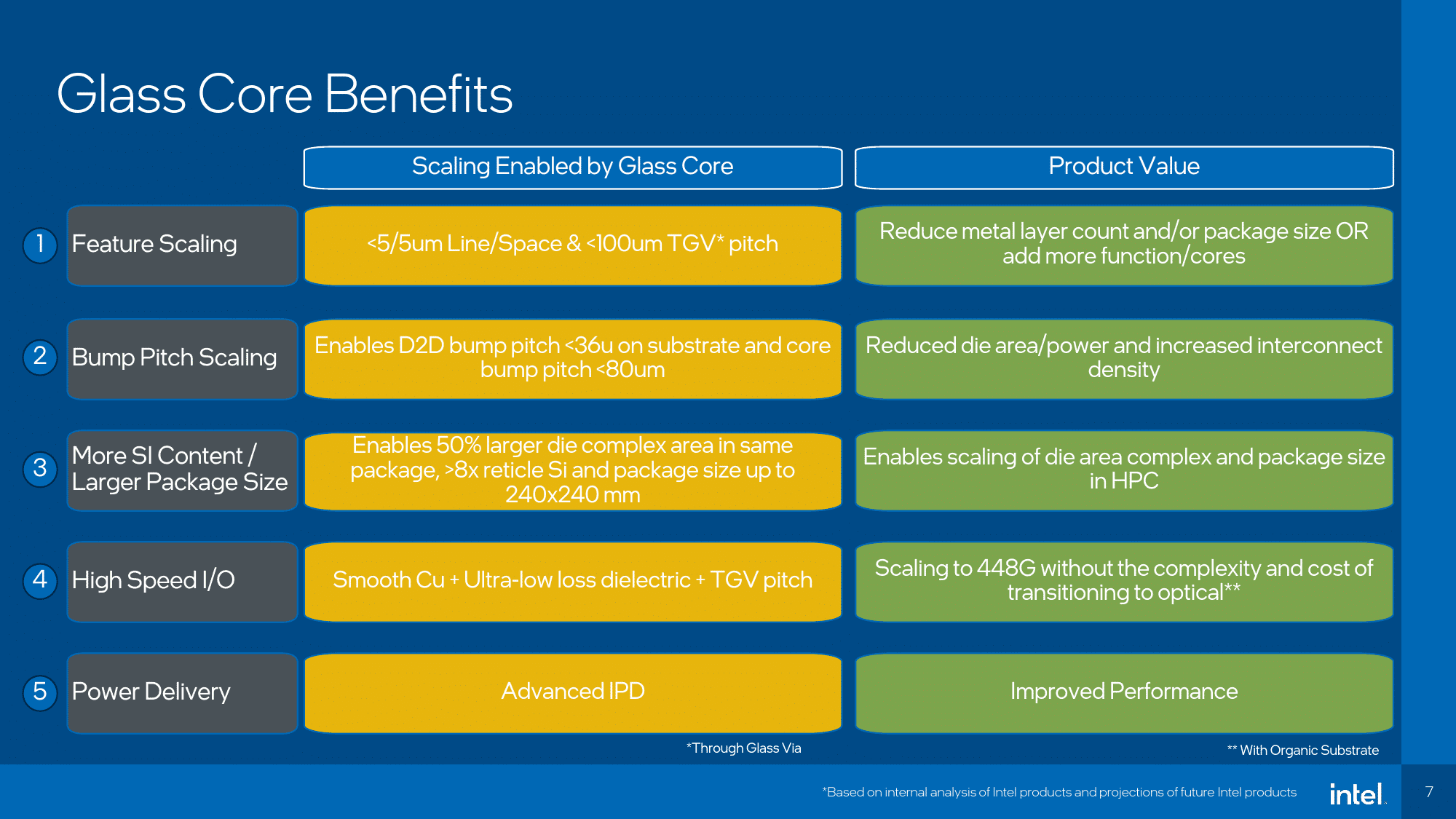
Intelは、このガラス基板は今後データセンター、AI、グラフィックス向けにゲームチェンジャー的なソリューションを構築することを可能にすると考えている。これにより、今後10年以内にシングルパッケージで1兆トランジスタという驚異的な数字を達成するための舞台が整う可能性があると同社は述べている。
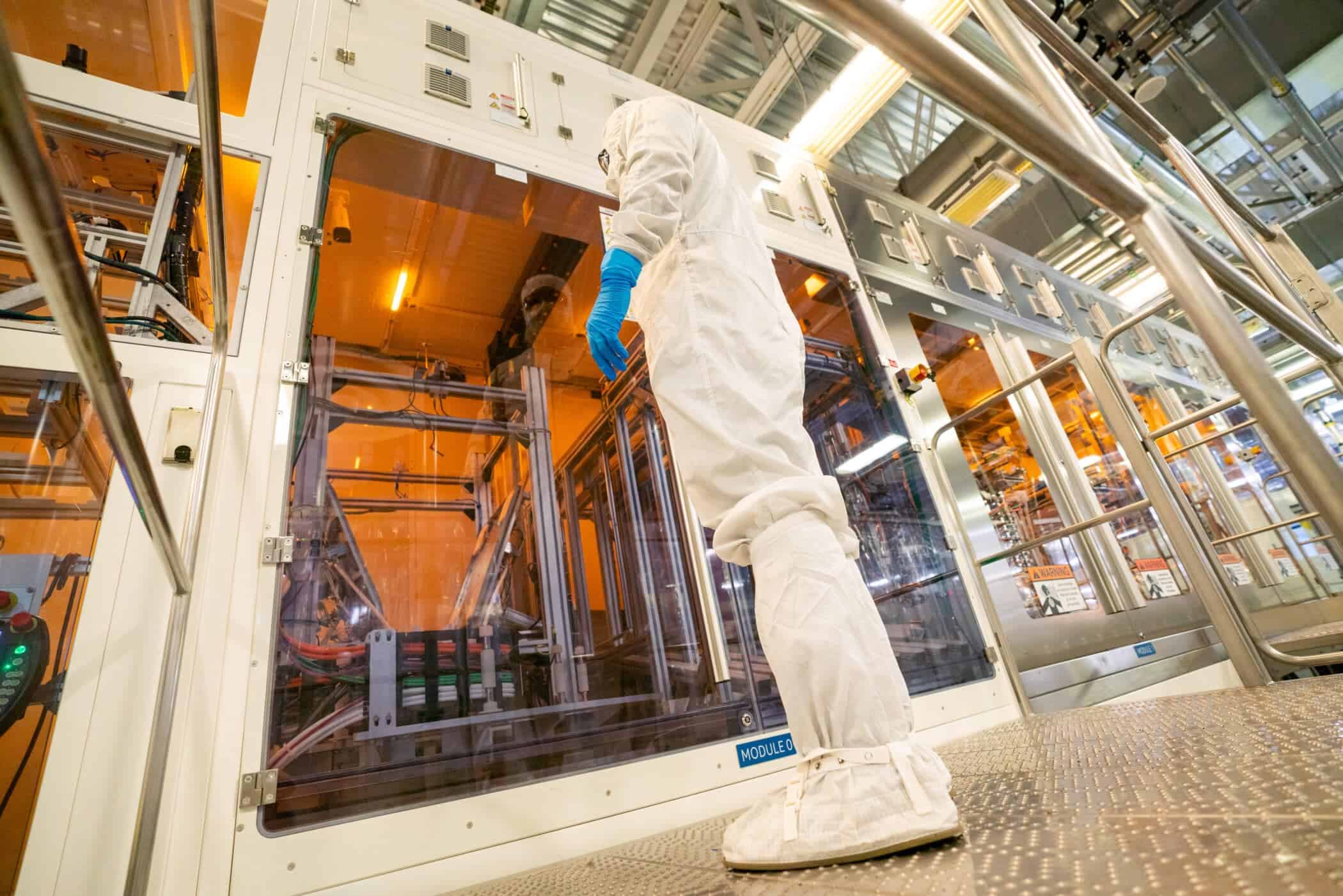
Intelによれば、これらのガラスパッケージ材を使った最初のチップは、「人工知能(AI)などのデータ集約型ワークロード」向けに2030年までに登場する予定だという。つまり、この新技術がコンシューマー向けPCやゲーミングPCに搭載されるにはまだ10年は待つことになるだろう。
Source