Intelは、現在の先進的なパッケージング技術の活用について説明会を開催し、いくつかの興味深い新たな技術を披露している。同社は、既存のチップ基板のガラス化により、チップ基板の強度が向上するだけでなく、エネルギー伝送効率がさらに向上すると予想している。Co-Packaged Opticsは、ガラス基板設計に移行することで光伝送によるデータ交換に利用できる帯域幅を拡大し、同時にチップのホットスワップも可能にするとしている。
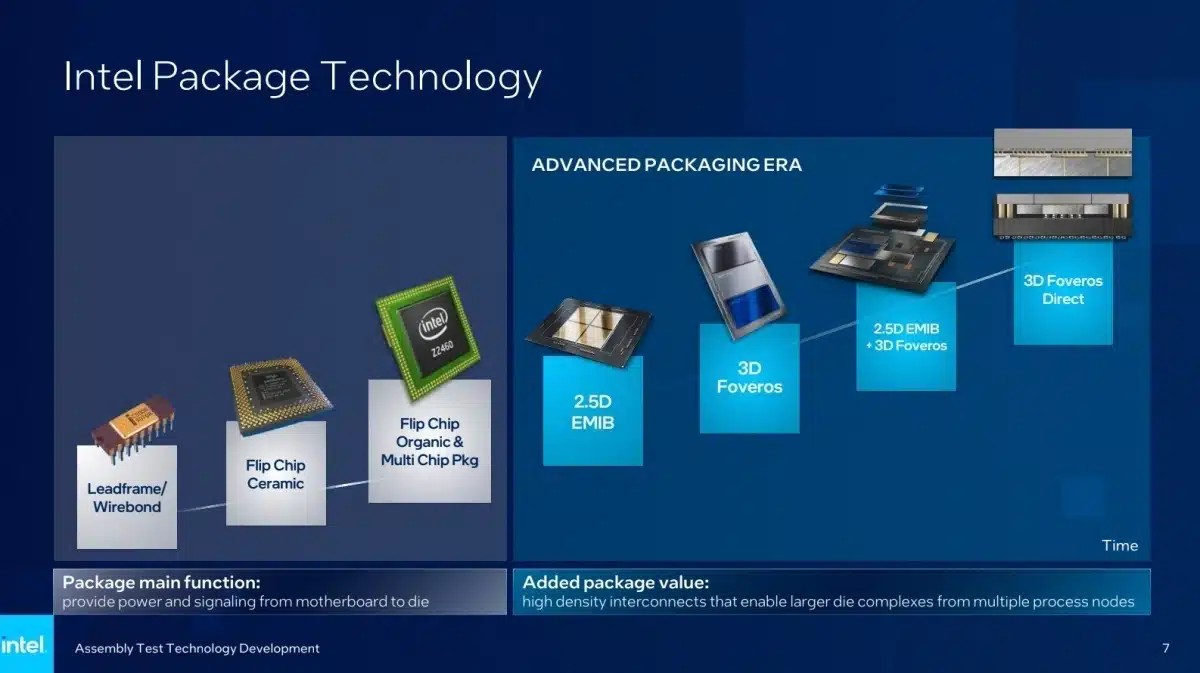
Intelが、これに先立ち提唱したIDM2.0開発戦略において、ファウンドリー事業はIntelの重要な変革プロジェクトとなり、Qualcommなどのチップ設計企業が自社の生産ラインのリソースを通じて製品を製造できるようになるだけでなく、例えば他社がファウンドリーを手伝い、Intelの技術を通じてパッケージやテストを行うなど、自社のパッケージ技術だけを採用する企業が増えることになる。これにより、より柔軟な方法で彼らのビジネスの成長機会を増やすことが可能となる。
Intelは、すでに世界のトップ10チップパッケージングハウスの顧客と交渉中であり、業界ではCiscoやAWSに支持されているという。

IntelはEMIB 2.5DおよびFoveros 3D技術により、小型チップアーキテクチャ、チップミキシングアーキテクチャ用のパッケージを実現することができたが、これらの技術は今後も進歩し、組み合わせて利用できるようになるだろう。
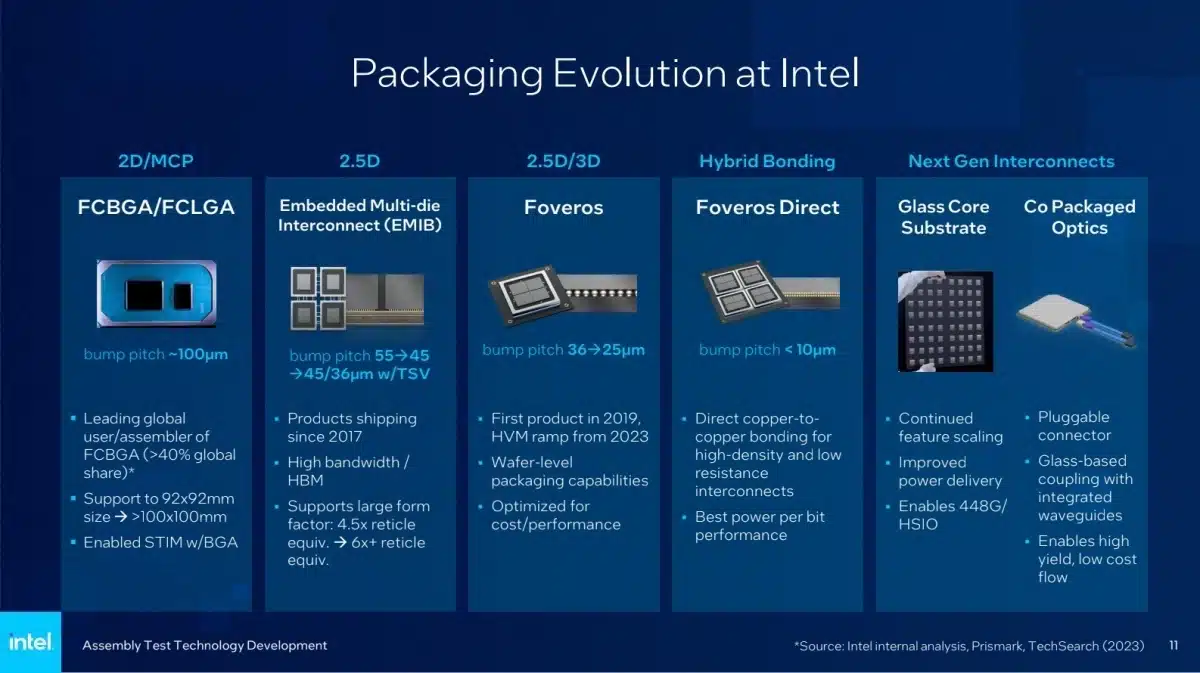

また、Intelはこれまで、より柔軟なプロセッサ・アーキテクチャ設計に対応するため、3Dスタッキングを使用してプロセッサ・ダイ間の接続を強化するFoveros Omniパッケージング・テクノロジーや、Foveros Omniの補完設計となるFoveros Directなど、Foveros 3Dパッケージングの強化技術の開発に言及しており、いずれも2023年に提供される予定だ。
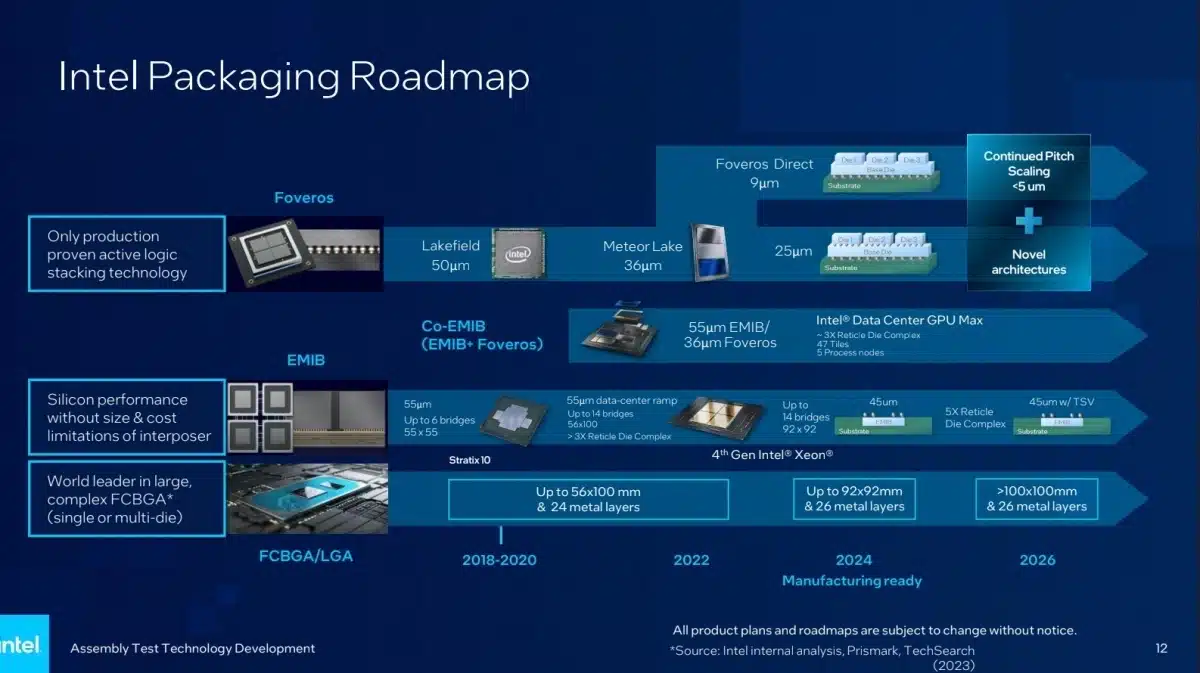
今後のパッケージ技術開発については、Intelは、既存のチップ基板をガラス化し、チップ基板の強度とエネルギー伝送効率を向上させるとともに、光伝送によるデータ交換帯域幅を拡大し、ホットスワップ方式でのチップの使用を可能にするために、光学部品技術のコ・パッケージ化に取り組む予定だという。
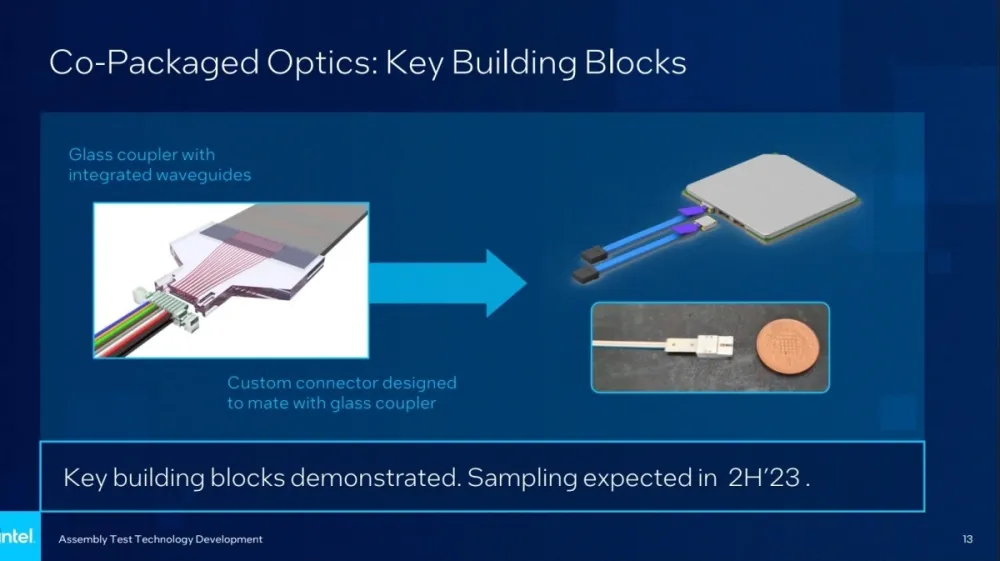
Intelは、本年第2四半期にテスト用のサンプルを提供する予定だ。
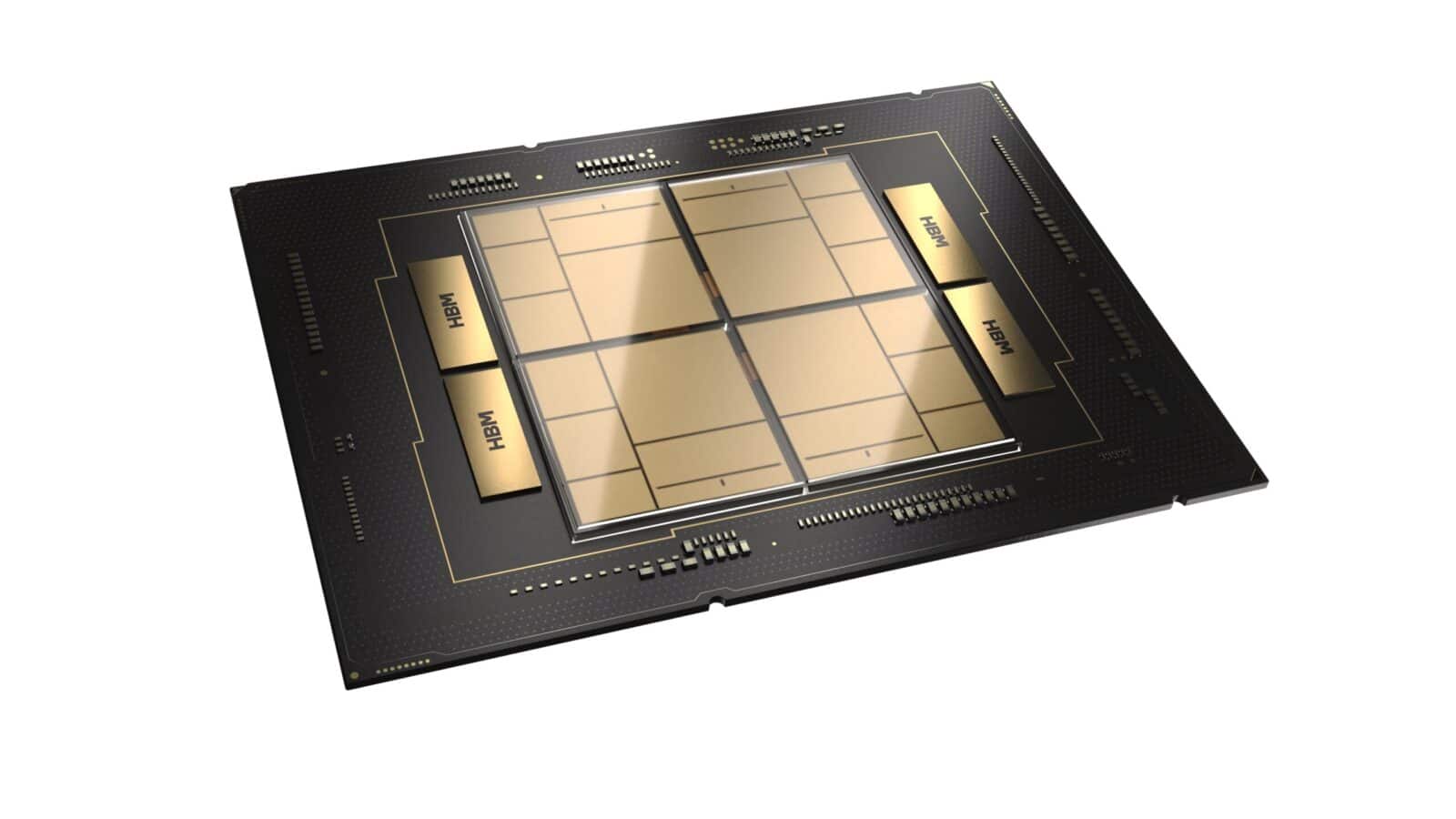







コメントを残す